
联系部门:罗小(xiǎo)姐
联系電(diàn)话:136-3169-2183
传真号码:0755-81737007
QQ号码:189773627
電(diàn)子邮箱:[email protected]
公司地址:深圳市宝安區(qū)燕罗街(jiē)道塘下涌社區(qū)安润路2号101,201,301

-
 石金石墨
石金石墨
-
 扫描二维码
扫描二维码

咨询热線(xiàn)
0755-27565656深圳市石金科(kē)技股份有(yǒu)限公司
联系電(diàn)话:0755-27565656
電(diàn)子邮箱:[email protected]
公司地址:深圳市宝安區(qū)燕罗街(jiē)道塘下涌社區(qū)安润路2号101,201,301
1
实验
1.1 实验设计
1.1.1 实验材料、设备
实验材料:本实验所用(yòng)硅片為(wèi)市售常规p 型多(duō)晶硅片,尺寸為(wèi)156.75mm×156.75 mm,電(diàn)阻率為(wèi)1~3 Ω•cm,厚度為(wèi)180±30 μm。
实验设备:使用(yòng)RENA 制绒设备制绒,采用(yòng)Cent r o therm 管式PECVD 设备及设备自身配置的石墨舟镀膜,采用(yòng)致东光電(diàn)D8-4 绒面反射仪测试硅片反射率,采用(yòng)s entech 激光椭偏仪测试硅片镀膜后的膜厚及折射率,使用(yòng)GP COl-Q 颜色检验设备测试镀膜后硅片的颜色。
1.1.2 片内、片间均匀性表征方式
镀膜均匀性包括片内均匀性和片间均匀性两方面。
1) 片内均匀性表征方式。镀膜后的硅片用(yòng)同一激光椭偏仪测试膜厚和折射率,用(yòng)于测试的5片硅片均取自同一位置,每片硅片均测试5 个固定点,即1 个中心点和4 个角,根据测试数据用(yòng)标准差来表征片内均匀性。
2) 片间均匀性表征方式。使用(yòng)GP COl-Q 颜色检验设备测试镀膜后硅片的颜色,根据测试数据用(yòng)标准差来表征片间均匀性。
1.2 实验内容
1) 本实验的PECVD镀膜工艺采用(yòng)双层镀膜,工艺参数对氮化硅薄膜的沉积速率有(yǒu)重要影响。為(wèi)保证数据的准确性,将同批次的硅片均匀分(fēn)為(wèi)若干组,在其他(tā)工艺条件相同的情况下依次改变以下参数:腔體(tǐ)内、外层气压,内层反应气體(tǐ)的配比,反应气體(tǐ)总气流量,腔體(tǐ)中反应温度,射频功率。
2) 测试不同硅片制绒面反射率对镀膜均匀性的影响。
3) 石墨舟是承载硅片的载體(tǐ),也是氮化硅薄膜沉积的载體(tǐ),石墨舟状态是否良好会直接影响氮化硅薄膜沉积的均匀性。实验对比新(xīn)、旧石墨舟对镀膜均匀性的影响。
2
结果与分(fēn)析
2.1 工艺参数对镀膜均匀性的影响
2.1.1 腔體(tǐ)内、外层气压
表1 為(wèi)腔體(tǐ)内层气压固定时,不同的外层气压对镀膜均匀性的影响。

由表1 可(kě)知, 当内层气压為(wèi)固定的1700mTorr、外层气压分(fēn)别為(wèi)1500~1800 mTorr 时,外层气压越低,片间均匀性的数值越小(xiǎo),表明其均匀性越好。而片内均匀性的数值越小(xiǎo),表明其均匀性有(yǒu)改善的趋势。


本次实验中发现,外层气压并非越低越好。当外层气压分(fēn)别為(wèi)1500~1700 mTorr 时,经管式PECVD 镀膜后,硅片外观正常。但经过高温退火处理(lǐ)后,采用(yòng)Zeta 3D 显微镜观察发现,外层气压為(wèi)1500 mTorr 时,硅片表面出现了密集的小(xiǎo)白点,為(wèi)花(huā)斑片;外层气压為(wèi)1600 mTorr 时,偶尔会出现花(huā)斑片;外层气压
為(wèi)1700 mTorr 时,无花(huā)斑片。因此,外层气压為(wèi)1700 mTorr 时最佳。图1 為(wèi)在不同外层气压下镀膜并高温退火后在Zeta 3D 显微镜下的硅片表面对比图。
硅片表面出现小(xiǎo)白点的原因主要是由于随着外层气压降低,等离子體(tǐ)沉积速率降低,膜层结构致密[3]。在膜层结构致密的情况下,高温退火处理(lǐ)时内层的Si-N 和N-H 键被破坏,大量氢原子逸出薄膜表面[4-5],而外层高致密膜阻挡了氢原子溢出,薄膜就容易起泡,产生针孔状小(xiǎo)白点[6]。
表2 為(wèi)腔體(tǐ)外层气压固定时,不同的内层气压对镀膜均匀性的影响。由表2 可(kě)知,内层气压越低,硅片片内均匀性略有(yǒu)改善,但片间均匀性变差。

2.1.2 内层反应气體(tǐ)的配比
表3為(wèi)外层氮硅比(即氨气和硅烷气體(tǐ)的比值)不变时,不同内层氮硅比对镀膜均匀性的影响。

由表3 可(kě)知,当外层氮硅比不变时,适当增加内层氮硅比,片内及片间均匀性均得到改善。其原因在于增加内层氮硅比后,等离子气體(tǐ)中的活性硅离子含量下降,导致中间态物(wù)质Si(NH2)3下降,从而降低了氮化硅薄膜生产速率[7-8],改善了硅片片内及片间色差。
2.1.3 反应气體(tǐ)总气流量
将同批次实验硅片均匀分(fēn)為(wèi)3 组,每组240 片,内层反应气體(tǐ)的氮硅比固定為(wèi)4.079,外层反应气體(tǐ)的氮硅比固定為(wèi)10.256;然后改变反应气體(tǐ)总气流量,观察其对镀膜均匀性的影响,具體(tǐ)影响情况如表4 所示。
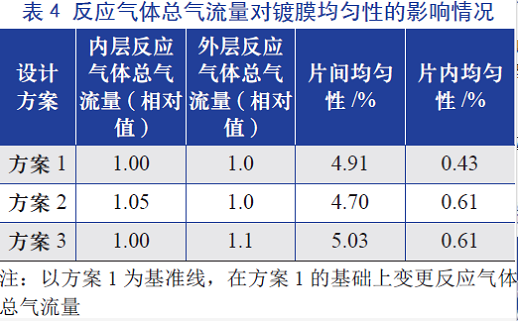
由表4 可(kě)知,内层反应气體(tǐ)总气流量相对较小(xiǎo),增加内层反应气體(tǐ)总气流量可(kě)改善腔體(tǐ)内反应气體(tǐ)的气體(tǐ)分(fēn)布密度,缩小(xiǎo)片间差异[9],改善片间均匀性。但是提高腔體(tǐ)内层或外层反应气體(tǐ)总气流量,单位體(tǐ)积内等离子气體(tǐ)中的活性硅离子含量也随之增加[8],薄膜生長(cháng)速率增加,导致片内均匀性明显变差。
2.1.4 射频功率
射频功率是影响沉积速率的主要因素,射频功率越大,沉积速率越大[6],镀膜均匀性越差。表5 為(wèi)射频功率对镀膜均匀性的影响,由图可(kě)知,射频功率增至8000 W时,片间、片内均匀性均变差。

2.1.5 腔體(tǐ)中反应温度
腔體(tǐ)中反应温度的控制主要表现在调节石墨舟各温區(qū)的直接链接变量(direct link varaiation,DLV) 和清理(lǐ)腔體(tǐ)内部碎片这两方面。图2 為(wèi)石墨舟各温區(qū)的示意图。

图3 為(wèi)同机台、同炉管时,调节DLV 值控制腔體(tǐ)中石墨舟各區(qū)温度对硅片片间均匀性的影响。可(kě)以看出,调节DLV 后硅片内部厚度标准偏差有(yǒu)所降低,说明改善了硅片片间均匀性。

图4 為(wèi)调节DLV 值前后石墨舟各温區(qū)片间均匀性对比情况。由图4 可(kě)知,DLV 调节后石墨舟各温區(qū)片间均匀性得到改善。

腔體(tǐ)内碎片过多(duō)会影响热電(diàn)偶测温,使腔體(tǐ)内实际温度和测定温度不一致,导致等离子在石墨舟内硅片上沉积速率存在差异[10],同时还会影响腔體(tǐ)内部进气及气流传输过程的稳定性,导致片间均匀性变差。因此需要对腔體(tǐ)内部碎片进行清理(lǐ)。图5 為(wèi)同一机台掏炉管清理(lǐ)腔體(tǐ)内部碎片前后硅片片间均匀性的差异。

图6 為(wèi)掏炉管清理(lǐ)腔體(tǐ)内部碎片前后石墨舟内各温區(qū)片间均匀性的差异。由图可(kě)知,各温區(qū)片间均匀性均有(yǒu)明显改善。